生成式AI层出不穷
算力需求集中爆发
近年来,包括 DeepSeek、ChatGPT等在内的生成式AI通过深度学习和海量数据训练,在文本、图像、语音等领域展现出强大能力,正在重塑内容创作、搜索引擎、智能客服等行业,在提高生产效率的同时也催生了巨大的算力需求。而训练类似大型语言模型所需的算力已从2018年的千万亿次浮点运算(TFLOPS)跃升至如今的百亿亿次(ExaFLOPS)级别,这种需求对芯片的设计与制造提出了新挑战。面对这一变革,全球科技企业正在加大投入,推动的计算硬件和基础设施建设,以支撑AI产业的快速发展。

图片来源:Shutterstock
芯片算力面临瓶颈
数据传输有待“交通升级”
过去,芯片的性能提升主要依赖于摩尔定律——即每隔月18-24个月,芯片上的晶体管数量就会翻倍,从而增强算力。然而,随着芯片制造技术越来越接近物理极限,这一定律正在放缓。单纯依赖架构优化和制程微缩已难以支撑生成式AI等高算力应用的需求。
如果将芯片比作一座城市,计算核心(GPU)是工厂,数据是货物,那么封装技术就是交通系统。传统封装如同狭窄的单车道,数据流通受阻,计算资源难以充分发挥。
与之相对的是,包括热压键合(TCB)、混合键合(HB)在内的先进封装技术,不再完全受限于单一芯片的优化,而是借助多芯片集成与封装实现芯片整体性能的跨越式增长,为数据传输构建起立体高速公路,通过在一定占用面积下实现更多的功能或减小实现某一功能所需占用的面积,提高计算核心间的协作效率和整体算力利用率。
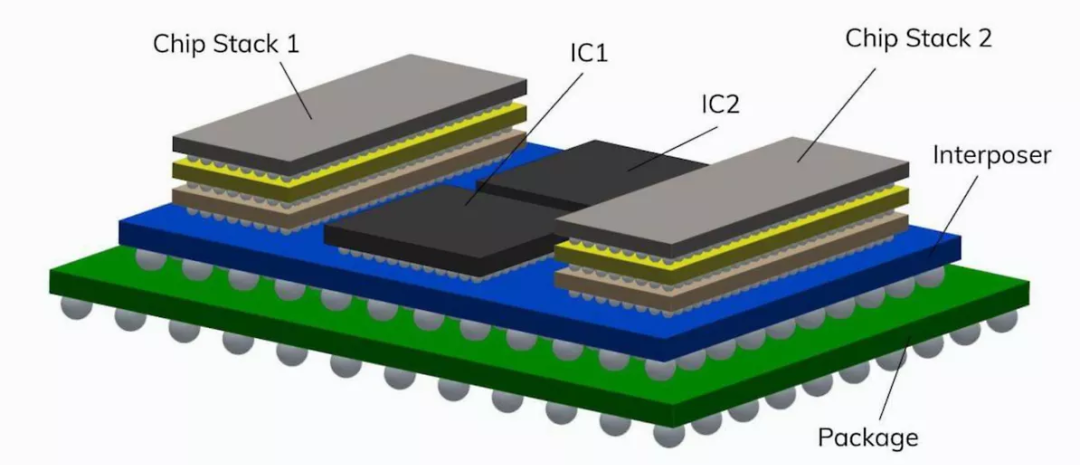
对于生成式AI而言,这种“交通升级”至关重要。它不仅加速了数据吞吐,让多个GPU协作,还通过多芯片集成(如Chiplet架构)将计算与存储紧密融合,节省空间的同时大幅提升系统性能。
由此,先进封装技术突破不仅契合AI时代对算力的需求,更成为芯片厂商提升产品性能、抢占市场先机的战略级工具。尤其对于中国市场而言,随着汽车智能驾驶与电动化、生成式AI以及自动化AIoT的迅猛发展,对高性能算力的需求正呈现指数级增长态势。在此背景下,奥芯明与ASMPT凭借其先进封装解决方案和本土化合作为中国企业提供了兼具经济性的技术路径,助力中国芯片产业突破算力瓶颈,增强中国芯片产业韧性,推动技术自主可控进程。
TCB封装突破芯片瓶颈
奥芯明助力算力跃升
作为先进封装技术的领军企业,ASMPT和奥芯明在TCB等先进封装技术上持续深耕,构建起覆盖研发、量产到产业协同的全链路生态:
核心技术突破
FIREBIRD系列部分机型采用ASMPT开发的Fluxless(无助焊剂)TCB 技术,在行业对凸块尺寸和焊接精度要求不断提升的情况下,通过的等离子体(Plasma)去氧化技术规避传统的助焊剂去氧化所带来的残留物问题,从而确保复杂封装下的高良率与可靠性。同时,通过优化芯片互连架构,缩短信号传输路径超30%,大幅减少数据延迟,提高AI芯片训练与推理的数据吞吐量。此外,该技术还通过调整互连阻抗和热管理设计,使芯片在相同算力下功耗降低15%-20%,显著优化每瓦算力成本。

ASMPT FIREBIRD TCB 系列全自动热压式固晶系统
成本优势突出
FIREBIRD系列设备在性价比方面优势突出,以优化的生产流程实现高效、高速键合。该系列产品在全球占据领先的市场地位,于AI芯片、GPU和高带宽存储器(HBM)等下游领域广泛应用。
多样化与定制化能力
ASMPT和奥芯明提供覆盖先进封装流程的多元化设备产品线,涵盖从芯片粘接到表面贴装(SMT)的多种技术,支持从2D到3D的异构集成,灵活适配各类封装格式,满足多样化市场需求。此外,奥芯明可根据客户需求,定制TCB设备与工艺方案。例如,在AI加速器和高性能计算(HPC)处理器广泛采用的CoWoS(Chip-on-Wafer-on-Substrate)结构中,奥芯明与ASMPT提通过提供高精度、高可靠性的TCB设备满足了约80%的封装需求,实现AI计算、HPC等领域产品的更高性能。
提升下游产品的可及性和可负担性
下游产品的不断迭代对封装技术带来了越来越高的要求。业界普遍认为传统的Flux TCB无法达到的键合精度只能诉诸混合键合(HB)技术。HB以其小于10微米的超细间距和高互连密度著称,但其复杂的工艺流程和对前道技术的要求限制了广泛应用,其高额的成本也会转化为在消费端高昂的价格。在此背景下,ASMPT的Fluexless TCB技术横空出世,填补了Fluxless TCB和HB之间的技术空白,不仅实现了接近HB的高精度(0.5微米),其工艺相比HB而言也非常简化,不过多涉及前道工艺,在传统的封测厂商(OSAT)中都可以进行应用,大大降低整体成本。该技术为AI、HPC以及在数字化时代涉及普通人生活方方面面的应用领域提供了更具性价比的解决方案,展现出强大的市场竞争力。
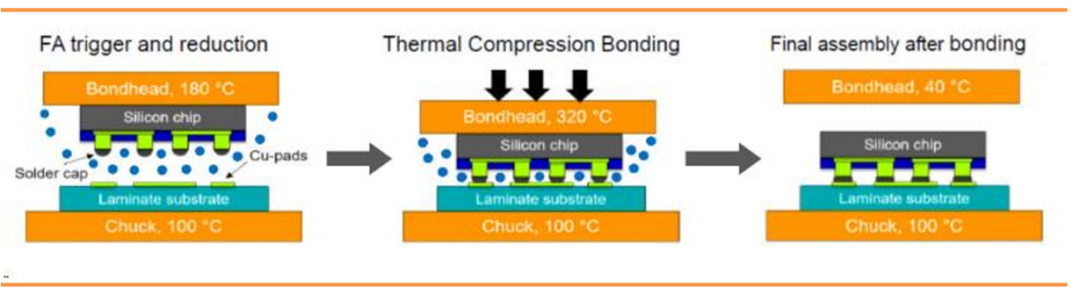
Fluxless TCB 工艺流程,仅供参考(图片来源:电子工程专辑)
技术助力芯片封装
协同产业驱动AI发展
热压键合(TCB)等先进封装技术正推动AI芯片性能持续突破,奥芯明正凭借技术创新、量产优化和产业生态协同的全链路优势,助力AI芯片封装迈向新高度,加速行业进入更可靠的算力新时代。
“
未来,随着AI应用场景的拓展,奥芯明期待继续发挥技术优势,为生成式AI的发展注入强劲动力,打造更更智能的未来计算平台。