
手 机:+86 139 2573 3686
邮 箱:sales@bestsoon-china.com
电 话:+86-755-23016560
网 址:www.bestsoon-china.com
地 址:深圳市宝安区新桥街道上星社区上星路万科星城商业中心2栋613

封装工艺流程
熟悉封装工艺流程是认识封装技术的前提,是进行封装设计、制造和优化的基础。
芯片封装和芯片制造不在同一工厂完成
它们可能在同一工厂不同的生产区、或不同的地区,甚至在不同的国家。许多工厂将生产好的芯片送到几千公里以外的地方去做封装。芯片一般在作成集成电路的硅片上进行测试。在测试中,先将有缺陷的芯片打上记号(打一个黑色墨点),然后在自动拾片机上分辨出合格的芯片。
1、封装工艺流程概况
流程一般可以分成两个部分:在用塑料封装之前的工序称为前段工序,在成型之后的操作称为后段工序。成型工序是在净化环境中进行的,由于转移成型操作中机械水压机和预成型品中的粉尘达到1000级以上(空气中0.3μm粉尘达1000颗/m3以上)。
现在大部分使用的封装材料都是高分子聚合物,即所谓的塑料封装。上图所示的塑料成型技术有许多种,包括转移成型技术、喷射成型技术、预成型技术,其中转移成型技术使用比较普遍。

2、芯片切割
2.1、为什么要减薄
半导体集成电路用硅片4寸厚度为520μm,6寸厚度为670μm。这样就对芯片的切分带来困难。因此电路层制作完成后,需要对硅片背面进行减薄,使其达到所需要的厚度,然后再进行划片加工,形成一个个减薄的裸芯片。
2.2、减薄工艺
硅片背面减薄技术主要有:
磨削、研磨、化学抛光、干式抛光、电化学腐蚀、湿法腐蚀、等离子增强化学腐蚀、常压等离子腐蚀等。
减薄后硅片粘在一个带有金属环或塑料框架的薄膜(常称为蓝膜)上,送到划片机进行划片。现在划片机都是自动的,机器上配备激光或金钢石的划片刀具。切割分部分划片(不划到底,留有残留厚度)和完全分割划片。对于部分划片,用顶针顶力使芯片完全分离。划片时,边缘或多或少会存在微裂纹和凹槽这取决于刀具的刃度。这样会严重影响芯片的碎裂强度。
先划片后减薄和减薄划片两种方法
在背面磨削之前,将硅片的正面切割出一定深度的切口,然后再进行磨削。
在减薄之前先用机械的或化学的方法切割出一定深度的切口,然后用磨削方法减薄到一定厚度后,采用常压等离子腐蚀技术去除掉剩余加工量。
这两种方法都很好地避免了或减少了减薄引起的硅片翘曲以及划片引起的边缘损害,大大增强了芯片的抗碎能力。
2.3、芯片贴装
芯片贴装,也称芯片粘贴,是将芯片固定于封装基板或引脚架芯片的承载座上的工艺过程。
贴装方式
共晶粘贴法
焊接粘贴法
导电胶粘贴法
玻璃胶粘贴法
2.3.1.1共晶粘贴法
共晶反应
指在一定的温度下,一定成分的液体同时结晶出两种一定成分的固相反应。例如,含碳量为2.11%-6.69%的铁碳合金,在1148摄氏度的恆温下发生共晶反应,产物是奥氏体(固态)和渗碳体(固态)的机械混合物,称为“莱氏体”。
一般工艺方法
陶瓷基板芯片座上镀金膜-将芯片放置在芯片座上-热氮气氛中(防氧化)加热并使粘贴表面产生摩擦(去除粘贴表面氧化层)-约425℃时出现金-硅反应液面,液面移动时,硅逐渐扩散至金中而形成紧密结合
预型片法
此方法适用于较大面积的芯片粘贴。优点是可以降低芯片粘贴时孔隙平整度不佳而造成的粘贴不完全的影响。
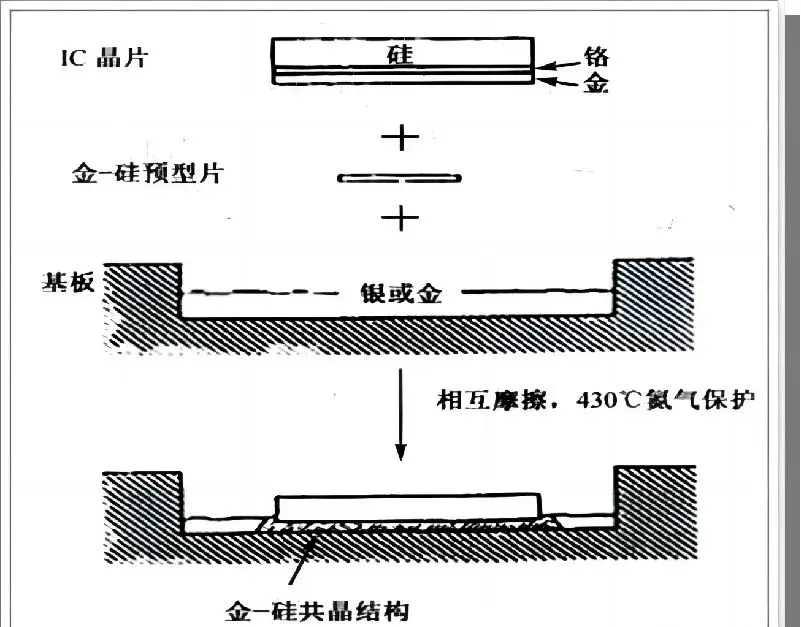
2.3.1.2焊接粘贴法
焊接粘贴法是利用合金反应进行芯片粘贴的方法。优点是热传导性好。
一般工艺方法
将芯片背面淀积一定厚度的Au或Ni,同时在焊盘上淀积Au-Pd-Ag和Cu的金属层。然后利用合金焊料将芯片焊接在焊盘上。焊接工艺应在热氮气或能防止氧化的气氛中进行。
合金焊料:
硬质焊料
软质焊料
硬质焊料:金-硅、金-锡、金-锗。
优点:塑变应力值高(“内应力”指组成单一构造的不同材质之间,因材质差异而导致变形方式的不同,继而产生的各种应力。当材料在外力作用下不能产生位移时,它的几何形状和尺寸将发生变化,这种形变称为应变。
材料发生形变时内部产生了大小相等但方向相反的反作用力抵抗外力.把分布内力在一点的集度称为应力。物体由于外因而变形时,在物体内各部分之间产生相互作用的内力,以抵抗这种外因的作用,并力图使物体从变形后的位置恢复到变形前的位置。在所考察的截面某一点单位面积上的内力称为应力。
按照应力和应变的方向关系,可以将应力分为正应力σ 和切应力τ,正应力的方向与应变方向平行,而切应力的方向与应变垂直。按照载荷作用的形式不同,应力又可以分为拉伸压缩应力、弯曲应力和扭转应力,具有良好的抗疲劳与抗潜变特性。
缺点:因材质的热膨胀系数不同而引发应力破坏。
软质焊料:铅-锡、铅-银-銦。
在焊接前先在芯片背面制作多层技术薄膜,目的是利用焊料的润湿。
使用软质焊料可消除硬质焊料的缺点。
2.3.1.3、导电胶粘贴法
导电胶是银粉与高分子聚合物(环氧树脂)的混合物。银粉起导电作用,而环氧树脂起粘接作用。
导电胶有三种配方:
(1)各向同性材料,能沿所有方向导电。
(2)导电硅橡胶,能起到使器件与环境隔绝,防止水、汽对芯片的影响,同时还可以屏蔽电磁干扰。
(3)各向异性导电聚合物,电流只能在一个方向流动。在倒装芯片封装中应用较多。无应力影响。
三种导电胶的特点是:化学接合、具有导电功能。
导电胶贴装工艺
膏状导电胶:
用针筒或注射器将粘贴剂涂布到芯片焊盘上(不能太靠近芯片表面,否则会引起银迁移现象),然后用自动拾片机(机械手)将芯片放置到焊盘的粘贴剂上,在一定温度下固化处理(150℃ 1小时或186℃ 半小时)。
固体薄膜:
将其切割成合适的大小放置于芯片与基座之间,然后再进行热压接合。采用固体薄膜导电胶能自动化大规模生产。
导电胶粘贴法的缺点是热稳定性不好,高温下会引起粘接可靠度下降,因此不适合于高可靠度封装。
2.3.1.4、玻璃胶粘贴法
与导电胶类似,玻璃胶也属于厚膜导体材料(后面我们将介绍)。不过起粘接作用的是低温玻璃粉。它是起导电作用的金属粉(Ag、Ag-Pd、Au、Cu等)与低温玻璃粉和有机溶剂混合,制成膏状。
在芯片粘贴时,用盖印、丝网印刷、点胶等方法将胶涂布于基板的芯片座中,再将芯片置放在玻璃胶之上,将基板加温到玻璃熔融温度以上即可完成粘贴。由于完成粘贴的温度要比导电胶高得多,所以它只适用于陶瓷封装中。在降温时要控制降温速度,否则会造成应力破坏,影响可靠度。
2.4、芯片互连
芯片互连是将芯片焊区与电子封装外壳的I/O引线或基板上的金属焊区相连接。
芯片互连常见的方法:
打线键合(WB wire bonding)
倒装芯片键合(FCB flip chip bonding,C4)
载带自动键合(TAB tape automate bonding)
这三种连接技术对于不同的封装形式和集成电路芯片集成度的限制各有不同的应用范围。
打线键合适用引脚数为3-257;载带自动键合的适用引脚数为12-600;倒装芯片键合适用的引脚数为6-16000。可见C4适合于高密度组装。
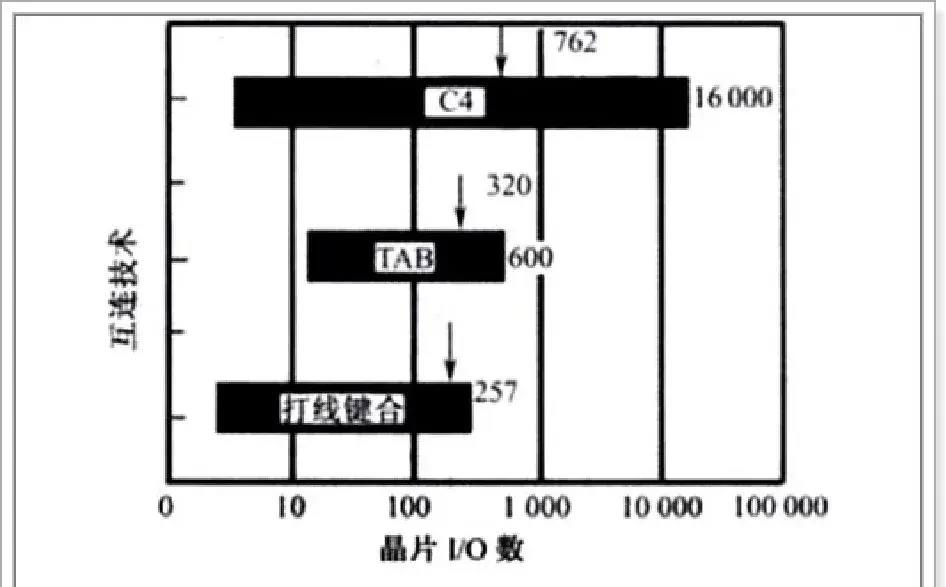
图2.3 各种连接技术依IC集成度区分的应用范围
2.4.1、打线键合技术
超声波键合(Ultrasonic Bonding ,U/S bonding)
热压键合(Thermocompression Bonding T/C bonding)
热超声波键合(Thermosonic Bonding,T/S bonding)
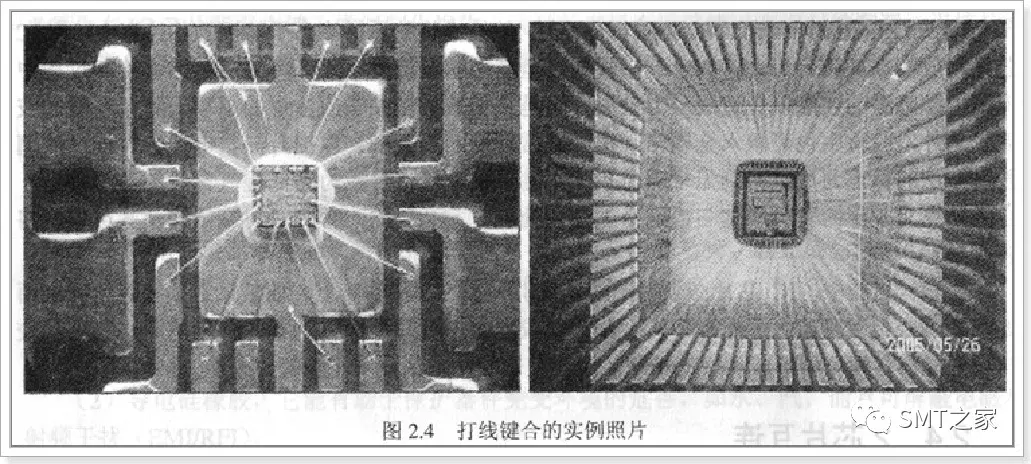
(1)超声波键合
优点:
键合点尺寸小,回绕高度低,适合于键合点间距小、密度高的芯片连接。
缺点:
所有的连线必须沿回绕方向排列(这不可能),因此在连线过程中要不断改变芯片与封装基板的位置再进行第2根引线的键合。从而限制了打线速度。

(2)热压键合
先将金属线穿过毛细管状的键合工具(称为瓷嘴或焊针),该工具是由碳化钨或氧化铝等耐高温材料制成;然后再电子点火或氢焰将金属线烧断并利用熔融金属的表面张力作用使线的末端灼烧成球(直径约为金属线直径的2-3倍),键合工具再将金属球压至已经预热到150-250℃的one金属焊垫上进行球形键合。
此时球形键合点受压稍有变形,其目的:
一是增加键合面积;
二是穿破表面氧化层,以形成紧密键合。球形键合完成后,键合工具升起并引导金属线至其二键合点上进行楔形接合(不需要烧成金属球,而是将金属线直接压到焊区上)。
由于键合工具顶端是圆锥形的,所以得到的焊点通常为新月状。
由于热压焊是在高温下进行的,通常使用的金属线为金线(抗氧化性强)。为降低成本有时也用铝线。铝线的2个焊接点是楔形的。原因是铝线不易在线的末端灼烧成球。
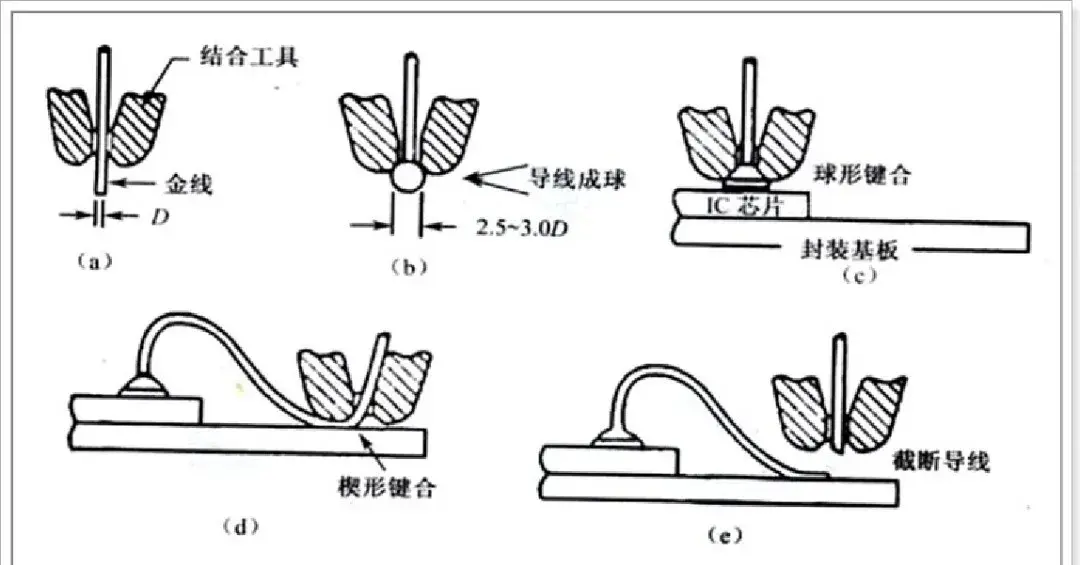
(3)热超声波键合
热超声波键合是热压键合与超声波键合的混合技术。在工艺过程中,先在金属线末端成球,再使用超声波脉冲进行金属线与金属接垫之间的接合。
此过程中接合工具不被加热,仅给接合的基板加热(温度维持在100-150℃)。其目的是控制键合界面的金属间化合物(类似于化学键,金属原子的价电子形成键)的成长,和降低基板高分子材料因高温产生形变。
打线键合的线材与可靠度
(1)合金线材
铝合金线
因纯铝线材太软很少使用。铝合金线标准线材是铝-1%硅。另外一种是含0.5-1%镁的铝导线。其优点是抗疲劳性优良,生成金属间化合物的影响小。
金线
纯金线的纯度一般用4个9。为增加机械强度,往往在金中添加5-10ppm 铍或铜。金线抗氧化性好,常用于超声波焊接中。
(2)影响打线键合可靠度因素
可靠度因素
封胶和粘贴材料与线材的反应
金属间化合物的形成
可靠度常用拉力试验和键合点的剪切试验测试检查
2.4.2、载带自动键合技术
载带自动键合技术是在类似于135胶片的柔性载带粘结金属薄片,(像电影胶片一样卷在一带卷上,载带宽度8-70mm。
在其特定的位置上开出一个窗口。窗口为蚀刻出一定的印刷线路图形的金属箔片(0.035mm厚)。
引线排从窗口伸出,并与载带相连,载带边上有供传输带用的齿轮孔。
当载带卷转动时,载带依靠齿孔往前运动,使带上的窗口对准带下的芯片。再利用热压模将导线排键合到芯片上。
可见TAB技术与一般的压丝引线技术不同。
后者的特点是将一根、一根的引线先后分立的快速的键合到搭接片上。TAB技术中内引线键合后还要做后道工序,包括电学测试、通电老化,外引线键合、切下,进行封装工艺。这些都在载带上完成。

过去,TAB技术不受重视的原因
(1)TAB技术初始投资大;
(2)开始时TAB工艺设备不易买到,而传统的引线工艺已得到充分的发展,且其生产设备也容易买到;
(3)有关TAB技术资料和信息少。但是随着芯片信息容量及随之而来的引脚数的增加,传统的分立引线工艺显得力不从心。为降低引线成本的需要,TAB技术越来越受到人们的青睐,促使许多半导体厂家开发研究。
TAB技术较之常用的引线工艺的优点:
(1)对高速电路来说,常规的引线使用圆形导线,而且引线较长,往往引线中高频电流的趋肤效应使电感增加,造成信号传递延迟和畸变,这是十分不利的。TAB技术采用矩形截面的引线,因而电感小,这是它的优点。
(2)传统引线工艺要求键合面积4mil2,而TAB工艺的内引线键合面积仅为2mil2这样就可以增加I/O密度,适应计算机与微处理器的更新换代。
(3)TAB技术中使用铜线而不使用铝线,从而改善器件的热耗散性能。
(4)在芯片封装前可进行预测试和通电老化。这样可剔除坏芯片,不使它流入下一道工序,从而节省了成本,提高了可靠性。
(5)TAB工艺中引线的键合平面低,使器件薄化。
2.4.2、载带自动键合技术
TAB技术的关键材料
基带材料:要求耐高温,与金属箔粘贴性好,热匹配性好,抗化学腐蚀性强,机械强度高,吸水率低。例如,聚酰亚胺(PI)、聚乙烯对本二甲酸脂(PET)和苯并环丁烯(BCB)
TAB金属材料:要求导电性能好,强度高,延展性、表面平滑性良好,与各种基带粘贴牢固,不易剥离,易于用光刻法制作出精细复杂的图形,易电镀Au、Ni、Pb/Sn焊接材料,例如,Al、Cu。
芯片凸点金属材料:一般包括金属Au、Cu、Au/Sn、Pd/Sn。
TAB的关键技术
。芯片凸点制作技术
。TAB载带制作技术
。载带引线与芯片凸点的内引线焊接和载带外引线焊接技术
TAB的关键技术--芯片凸点制作技术
IC芯片制作完成后其表面均镀有钝化保护层,厚度高于电路的键合点,因此在IC芯片的键合点上或TAB载带的内引线前端先长成键合凸块才能进行后续的键合,通常TAB载带技术也据此区分为凸块化载带与凸块化芯片TAB两大类。
地状金属凸块;单层载带可配合铜箔引脚的刻蚀制成凸块,在双层与三层载带上,因为蚀刻的工艺容易致导带变形,而使未来键合发生对位错误,因此双层与三层载带较少应用于凸块载带TAB的键合。
凸块式芯片TAB,先将金属凸块长成于IC芯片的铝键合点上,再与载带的内引脚键合。预先长成的凸块除了提供引脚所需要的金属化条件外,可避免引脚与IC芯片间可能发生短路,但制作长有凸块的芯片是TAN工艺的困难。
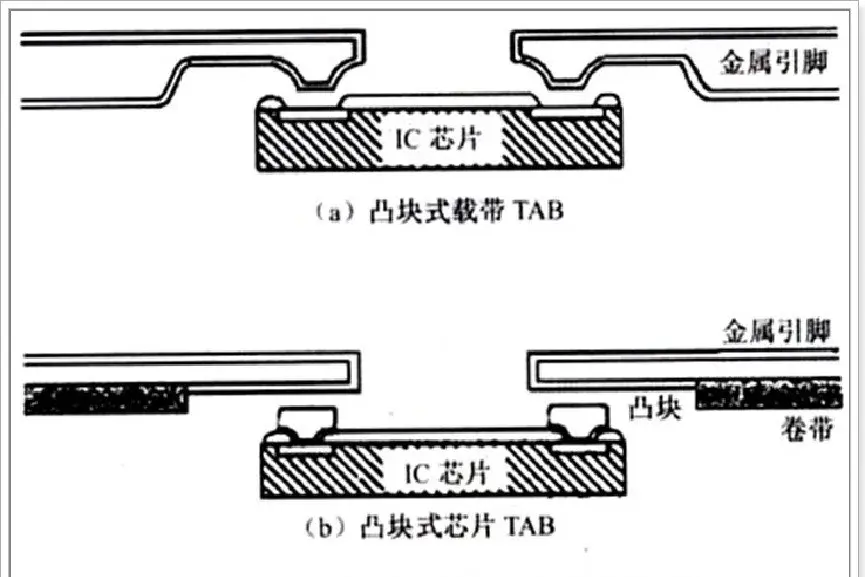
芯片凸点制作技术
凸点因形状不同可分为两种
蘑菇状凸点一般用光刻胶做掩膜制作,电镀时,光刻胶
以上凸点除了继续升高以外,还横向发展,凸点越来越高,横向也越来越大,所以凸点形状像蘑菇。随着横向发展电镀电流密度的不均匀性使得得到的凸点顶部成凹形,且凸点的尺寸也难以控制。
直状凸点制作是使用厚膜抗腐蚀剂做掩膜,掩膜的厚度与要求的凸点高度一致,所以始终电流密度均匀,凸点的平面是平整的。
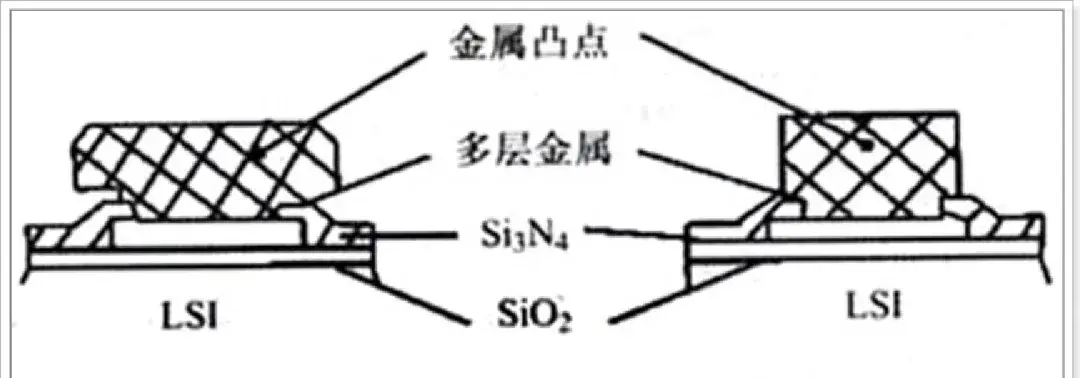
金凸块制作的传统工艺:
1,对芯片进行清洁处理
2,通过真空溅散的方法,在芯片键合的上表面形成粘着层和阻挡层。粘着层提供IC芯片上的铝键合点与凸块间良好的键合力与低的接触电阻特性。常用的材料是Ti、Cr、和Al,这几种金属的与铝和氧化硅的粘着性很好。扩散阻挡层的作用是阻止芯片上的铝与凸块材料之间的扩散反应而形成金属间化合物。
金属层做好后、接着涂25微米后的光刻胶,然后用电镀的方法制作金属凸块。凸块制作完成后在其顶面电镀一层25微米的金(凸块金属不是金的情况),目的是起抗氧化作用。
金凸块制作的传统工艺
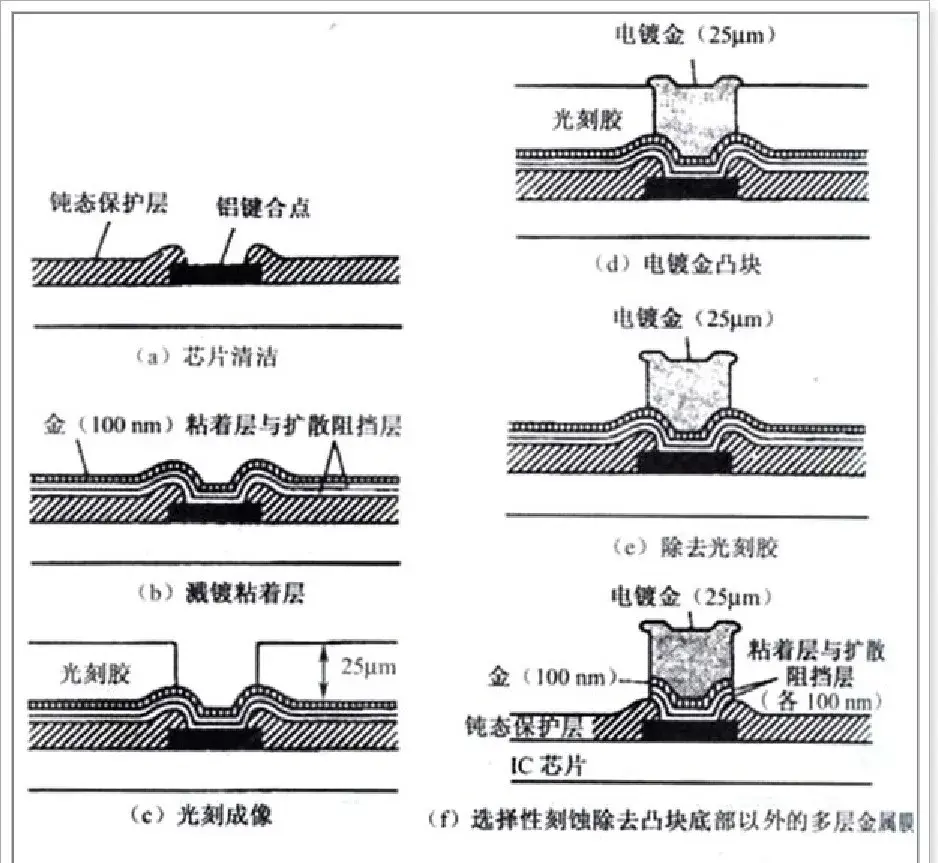
凸块转移技术
一般的凸块制作工艺流程,可以看出,它的制作工艺复杂,技术难度大,成本高。因此改进凸块制作技术成为一项研究的热门课题。
日本Matsushita公司开发了凸块转移技术。
这种技术分2次键合:
第1次是将在玻璃基板上做成的凸块,转移到载带内引脚前端与芯片键合点相对应的位置。
第2次键合。在引脚前端有凸点的载带由专门的制造商提供,这样就避免了在芯片焊区制作凸点的麻烦,降低了生产成本。
凸块转移技术
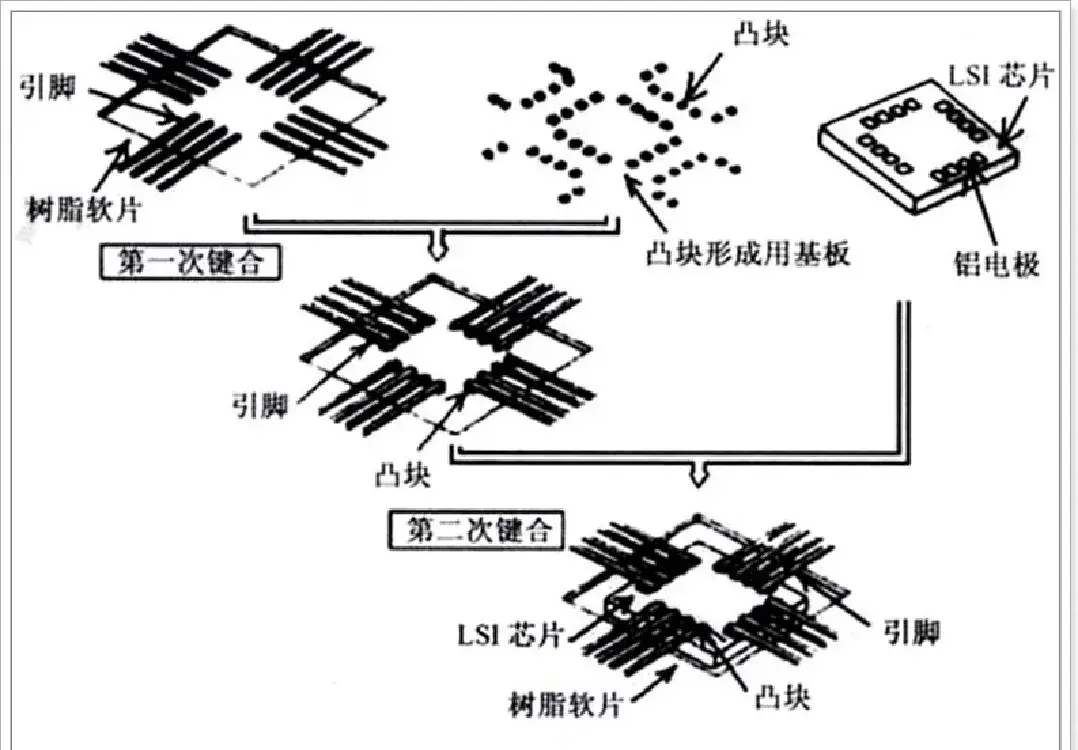
 公司名称:倍特盛电子科技有限公司
公司名称:倍特盛电子科技有限公司
富特盈智能设备有限公司
 联系电话: +86-755-23016560
联系电话: +86-755-23016560
 联系电话: +86 139 2573 3686 (赵先生)
联系电话: +86 139 2573 3686 (赵先生)
+86 137 9879 5391 (黄先生)
+86 133 0291 7860 (杨先生)
 公司传真: +86-755-23016560
公司传真: +86-755-23016560
 公司邮箱:sales@bestsoon-china.com
公司邮箱:sales@bestsoon-china.com
 公司地址:深圳 --宝安区新桥街道上星社区
公司地址:深圳 --宝安区新桥街道上星社区
上星路万科星城商业中心2栋613
香港 -- 九龙弥敦道540-544号
祥兴大厦11楼6室
苏州 -- 苏州工业园唯新路60号
26幢2603/2604

微信联系
